Цели и задачи сектора: |

|
|
Исследования структуры и элементного состава веществ методами электронной микроскопии, оптической спектроскопии и рентгеновской дифракции. Руководитель:д.ф.-м.н. Кульницкий Борис Арнольдович Сотрудники:
|
||
Виды и диапазоны измерений: |
|||
Электронная микроскопия |
|||

|
Просвечивающий электронный микроскоп JEM-2010 Ускоряющее напряжение 200 киловольт. Разрешение по линиям 0,14 нанометров. Оборудован приставкой энерго-дисперсионной спектороскопии, которая работает с характеристическим рентгеновским излучением и позволяет проводить элементный анализ, начиная с четвертого элемента в таблице Менделеева (бериллий). Требования к образцам:
|
||
| |
|||

|
Сканирующий электронный микроскоп JSM-7600F Сканирующий электронный аналитический микроскоп с термополевой эмиссией.
Оснащен спектрометрами для энерго-дисперсионного (ЭДС) и волно-дисперсионного (ВДС) анализа начиная с четвертого элемента в таблице Менделеева (бериллий). Требования к образцам:Диаметр до 26 мм, высота до 5 мм. Наличие режима мягкого пучка (от 100 В), допускает исследование непроводящих объектов без нанесения проводящего покрытия. |
||
Рентгеновская дифрактометрия и топография |
|||

|
Дифрактометрия: Порошковый дифрактометр для исследования структуры поликристаллических образцов TETA ARL X’TRA с детектором Пельтье Система ARL X'TRA работает в диапазоне углов 2θ от -8° до 160°, снабжена системой цифрового сервопривода высокого разрешения с оптическим декодером (точность декодера ± 0,00025 градуса). Прибор снабжен коллиматорными щелями Соллера 1,15° и гибкой системой щелей для отраженного излучения, постоянно подстраиваемой микрометром в диапазоне 0 - 10 мм. В качестве источника рентгеновского излучения используется Cu рентгеновская трубка с максимальной мощностью 2000 Вт. |
||
| |
|||
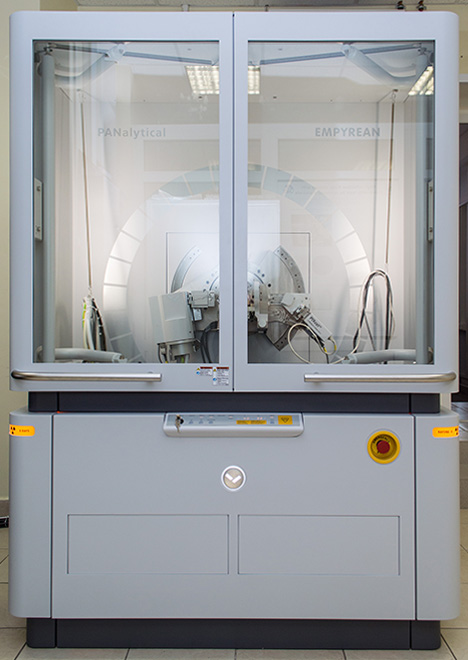
|
Универсальный дифрактометр Empyrean Empyrean – универсальный дифрактометр, предназначенный для исследования как поликристаллов, так и совершенных монокристаллов. Дифрактометр оснащен современными рентгенооптическими модулями и высокоскоростным высокочувствительным 2D полупроводниковым детектором PIXel 3D. Это позволяет реализовать с их помощью практически все методы рентгенодифракционного анализа, включая рентгеновскую томографию. |
||
| |
|||
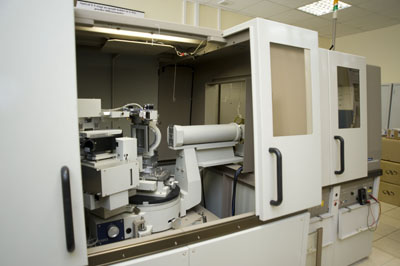 
|
Рентгеновская топография: Rigaku XRT-100CCM - рентгеновская дифракционная топографическая система с кристаллом-монохроматором Система используется для неразрушающего контроля структурного совершенства кристаллов с возможностью наблюдения линейных и планарных дефектов кристаллической решетки монокристаллов, таких как дислокации и дефекты упаковки. В ней реализованы следующие рентгенодифрактометрические методики:
Образцы должны представлять собой монокристаллические, либо блочные пластины диаметром менее 100 мм. Толщина образцов для съемки на просвет не должна превышать экстинкционной длины для конкретного материала анода. |
||
Оптическая спектроскопия |
|||
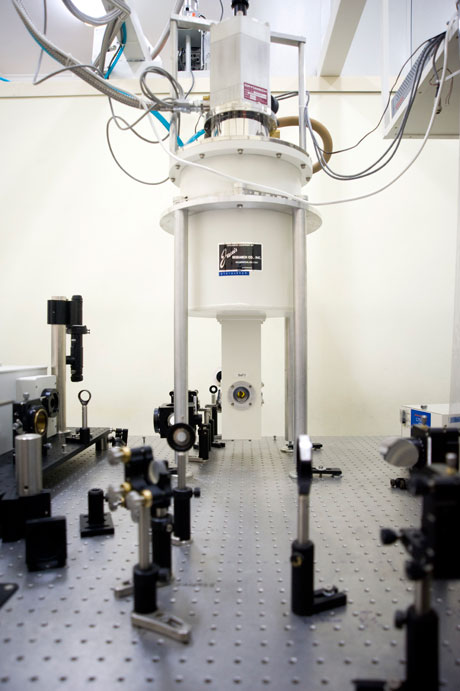
|
Спектроскопия колебательных переходов: Комбинационное рассеяние света (КРС). Спектроскопия электронных переходов: Фотолюминесценция. Лазеры для возбуждения спектров КРС и фотолюминесценции с длинами волн: 244, 257, 458, 488, 514, 568, 633 и 647 нм. Температурный диапазон измерений: 4,5 - 800 К для КРС и фотолюминесценции. |
||
| |
|||

|
Спектрофотометр Сary 4000
|
||
| |
|||

|
ИК Фурье-спектрометр Thermo Nicolet Nexus 470 FT-IR
|
||
| |
|||
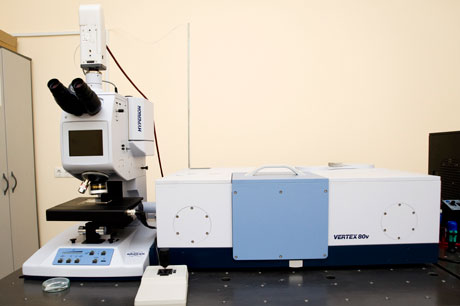
|
Вакуумный Фурье-спектрометр VERTEX 80v c ИК микроскопом HYPERION2000, криостатом от 80К и различными приставками
|
||
| |
|||
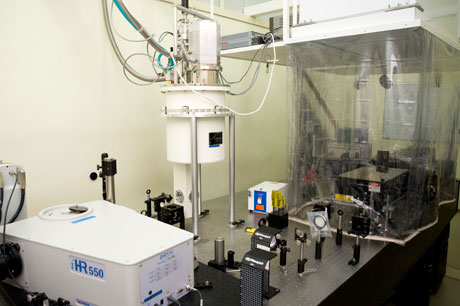
|
Комплекс всеволновой КРС-спектороскопии монокристаллов Интегральная оптическая система для оптических спектральных исследований в диапазоне температур от 5 до 800 К. |
||
| |
|||

|
Спектрометры TRIAX-552 и iHR550
(с низкотемпературными ССD, зеркальной оптикой и фильтрами для подавления лазерного излучения) снабженные
микроскопическими приставками и алмазными наковальнями
|
||
Требования к образцам: Образцы для ИК измерений должны быть либо измельчены в порошок с размерами частиц до 2 мкм, либо иметь полированные поверхности. При исследовании на просвет плёнок подложка должна быть из материала пропускающего ИК излучение. При исследовании методом КРС наноноструктурных порошков необходима тщательная химическая очистка от люминесцирующих примесей или использовать чистые материалы при получении этих порошков. |
|||